近日,南方科技大学深港微电子学院教授于洪宇团队在GaN器件研究中取得系列重要进展,研究成果相继发表在在国际微电子器件权威期刊IEEE Electron Device Letters(EDL)、Applied Physics Letters(APL)及IEEE Transactions on Electron Devices(TED)期刊上。
随着电力电子系统对器件更高功率密度、高效率、高频工作能力的持续需求,以及未来电力电子应用对小尺寸和低成本的需求,传统的硅基电力电子器件已接近其物理极限。在这种背景下,第三代半导体材料进入了公众视野。氮化镓(GaN)作为第三代半导体材料的代表,具有大的禁带宽度、高击穿电场、高电子饱和漂移速率等优良特性,已在手机快充领域实现商业化应用,并在智能电网、新能源汽车、数据中心、5G通讯和雷达等高频高功率领域表现出巨大的应用前景,被认为是下一代信息存储及智能制造技术的核心。我国“十四五计划”也提出以发展GaN器件为构建未来能源系统的目标,标志着 GaN材料与器件成为布局国家 “新基建”的关键核心之一。
面向大功率电源电路对常关型GaN器件的需求,于洪宇团队首次开发了两种新型的选择性区域生长技术,结合高质量原位SiNx钝化及原子层沉积工艺,制备了系列高性能免刻蚀常关型GaN凹栅MIS-HEMT器件。通常,GaN凹栅HEMT器件需要通过刻蚀定义出栅极区域,易引入离子损伤及表面缺陷。再生长技术可以有效改善刻蚀损伤问题,但整体流程为先栅工艺,难以制备高质量钝化材料。本研究首次在再生长技术中引入MOCVD原位SiNx钝化,并基于原位SiNx和再生长势垒层定义的凹栅结构,制备出常关型GaN MIS-HEMT器件,利用再生长及原位钝化工艺的优势,在保持高阈值电压(Vth > 2.5 V)的同时实现了世界最优水平之一的导通电阻及阈值电压迟滞。该工作有效抑制了选区再生长和原位SiNx工艺制备常关型GaN HEMT的技术缺陷,为开发低损伤常关型GaN功率器件提供了翔实的理论指导和技术支持。相关工作以“Normally-OFF AlGaN/GaN MIS-HEMTs With Low RON and Vth Hysteresis by Functioning In-Situ SiNx in Regrowth Process”为标题发表在IEEE EDL杂志上[1]。南科大深港微电子学院与香港理工大学联培博士生何佳琦为论文第一作者,于洪宇为通讯作者,南科大为论文第一单位,该工作也得到了香港理工大学教授李刚的支持。
器件结构
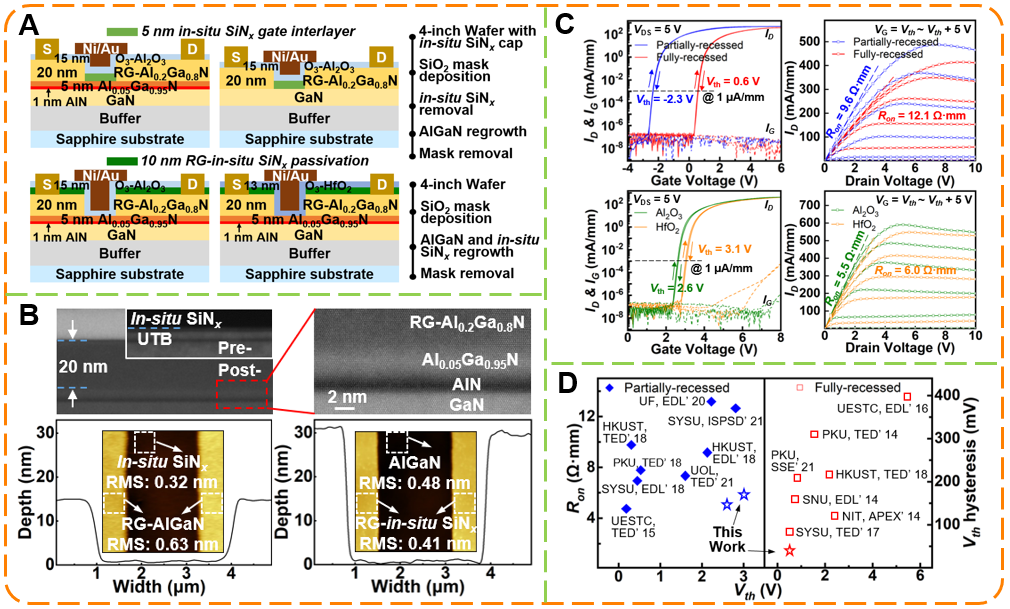
图1. A GaN MIS-HEMT器件结构; B 外延结构AFM/TEM; C常关型器件转移/输出特性; D阈值电压-导通电阻Benchmark 栅极击穿电压及其可靠性作为功率开关器件的关键性能指标,在工业生产及实际应用中具有重要研究价值。目前,高功率电源电路中的开关管采用p-GaN型栅常关型HEMT器件,但这种已经实现商业化生产的器件结构仍存在一定问题:器件的击穿电压通常较低;在较高的栅极驱动电压条件下,器件长期工作可靠性不足,器件容易损坏。为解决上述问题,于洪宇团队通过调控p-GaN在外延生长过程中的参数,有效降低了栅金属/p-GaN肖特基结的尖峰电场,在不影响其它性能如阈值电压、导通电阻等直流特性的情况下,制备出在10.6 V栅极驱动电压下具有10年工作可靠性的常关型HEMT器件。本研究所提出的u-GaN/p-GaN结构能有效提高功率转换系统的可靠性,相关工作以“p-GaN Gate HEMTs With 10.6 V Maximum Gate Drive Voltages by Mg Doping Engineering”为标题发表在IEEE TED杂志上[2]。南科大深港微电子学院与加拿大哥伦比亚大学联培博士周广楠为论文第一作者,于洪宇为通讯作者,该工作也得到了加拿大哥伦比亚大学教授夏光睿的支持。
器件结构
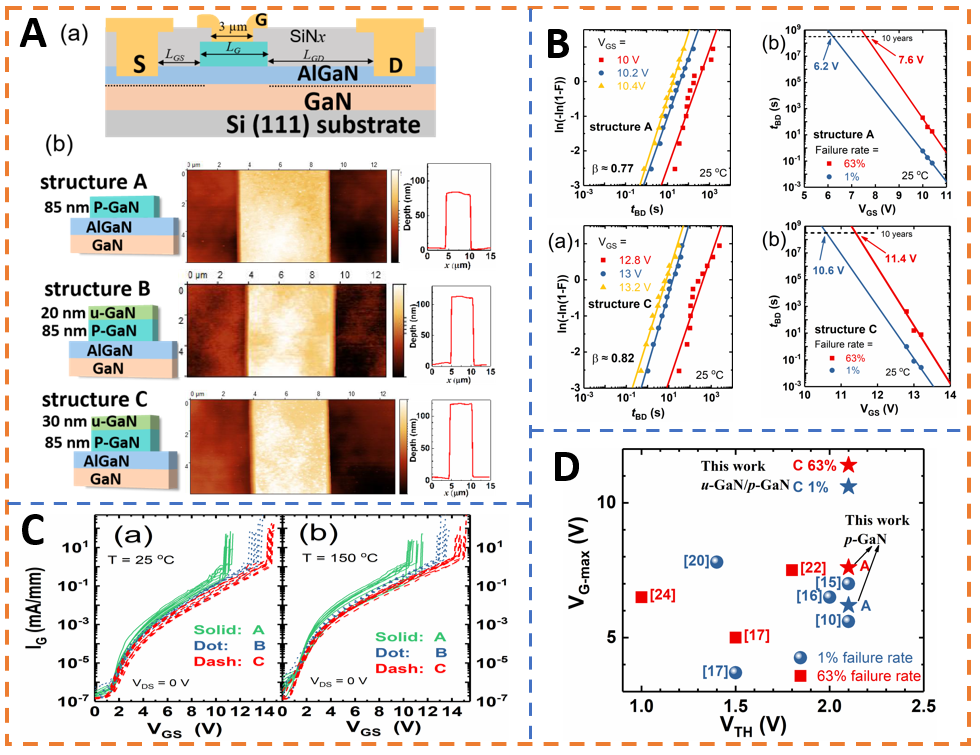
图2. A器件截面示意图及AFM表征结果; B威布尔图及器件使用寿命预测; C为(a)25℃和(b) 150℃时,器件的栅极击穿特性; D VG-max和VTH的Benchmark。 基于InAlN/GaN异质结构的GaN器件凭借高的二维电子气密度和较低的方块电阻,成为实现下一代低开关损耗、高功率密度、高开关速度电力电子器件的理想材料。为实现高性能的InAlN/GaN器件,降低源漏欧姆接触电阻是其关键工艺之一,于洪宇课题组提出了一种基于Si/Ti5Al1/TiN结构的无金欧姆接触方案(图3A)。相比于传统的有金欧姆接触工艺,该方案可有效兼容现有的Si基COMS工艺线,降低工艺成本和实现大尺寸。经优化退火温度,采用Si/Ti5Al1/TiN欧姆接触在InAlN/GaN异质结上实现了0.11 Ω·mm的超低欧姆接触电阻值,打破了InAlN/GaN异质结上合金欧姆接触的世界纪录(图3B),并可与采用再生长欧姆接触等更复杂的先进工艺效果相媲美。此外,利用透射电镜(TEM)等技术手段深入分析了其形成优异欧姆接触的微观机理,提出了该欧姆接触结构的形成机理(图3C),该方案为InAlN/GaN异质结上欧姆接触工艺的研发提供了新思路。相关成果以"Microscopic formation mechanism of Si/Ti5Al1/TiN ohmic contact on non-recessed i-InAlN/GaN heterostructures with ultra-low resistance"为标题已发表在权威期刊Applied Physics Letters (APL)上,南科大深港微电子学院访问博士生蒋洋为论文第一作者,于洪宇和研究副教授汪青为共同通讯作者,南科大为论文第一单位,该工作也得到了香港大学助理教授王中锐的支持。
器件结构
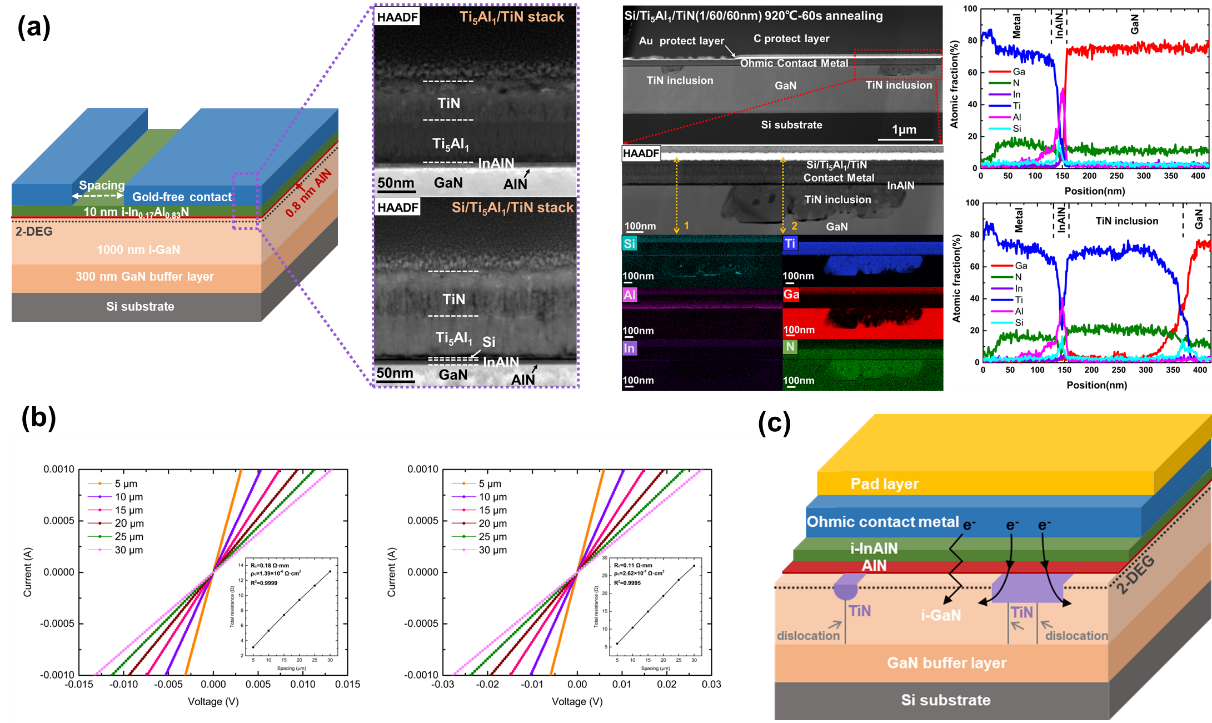
图3. InAlN/GaN异质结上无金欧姆接触。A Ti5Al1/TiN和Si/Ti5Al1/TiN无金欧姆接触结构示意图及其TEM分析结果; B I-V测试及欧姆接触结果拟合曲线; C 所提出的欧姆接触形成机理示意图。 GaN p-FETs不良的导通能力和关断能力严重限制了GaN CMOS逻辑或功率集成电路的最大工作频率,开发高性能GaN p-FETs成为实现高性能GaN CMOS需要解决的首要问题。器件源、漏电极处金属/半导体界面形成的欧姆接触是器件与外部电路连接的基础,其性能与器件输出源、漏电流、膝点电压、导通电阻、功率损耗及可靠性等性能密切相关,因此低阻欧姆接触关键技术的开发也是提升GaN p-FETs的器件性能的关键。于洪宇团队在GaN CMOS外延上开发出新型Mg/Pt/Au结构的p型欧姆接触,打破了GaN p-FETs及CMOS上p型欧姆接触制备困难的壁垒,比接触电阻率低至1.810-5 Ω2,达到该外延上世界最低水平。此外,实现了原位去除p-GaN表面氧化层的技术,在获得超低电阻欧姆接触的同时消除非原位表面处理技术对器件可靠性的影响。研究结果显示Mg接触层的引入促进了Pt层形成Au扩散通道,从而促使Au向内扩散与p-GaN接触,同时界面处的Au诱导Ga向外扩散形成Au-Ga相,并在p-GaN表面形成Ga空位提高空穴浓度,最终形成超低接触电阻率的欧姆接触。相关成果以" Ohmic Contact with a Contact Resistivity of 12 Ω·mm on p-GaN/AlGaN/GaN "为标题已发表在权威期刊IEEE EDL上,南科大深港微电子学院与哈工大联培博士生唐楚滢为论文第一作者,于洪宇和汪青为共同通讯作者,南科大为论文第一单位,该工作也得到了复旦大学教授蒋玉龙的支持。
器件结构

图4. A外延信息及制备流程; BI-V特性与电流范围关系和Rsh与温度关系图; CI-V特性图; D样品TEM及外延EDX line 测试结果; E样品TEM及XPS测试结果; F Rc随退火温度变化关系图及拟合提取电阻信息 以上工作获得国家自然科学基金面上项目、广东省重点领域研发计划项目、深圳市基础研究重点项目及深圳市自然科学基金面上项目的支持。
论文链接:
1 https://ieeexplore.ieee.org/document/9706449
2 https://ieeexplore.ieee.org/document/9737317
3 https://aip.scitation.org/doi/full/10.1063/5.0117205
4 https://ieeexplore.ieee.org/document/9834920
文章来源:南方科技大学
于洪宇,目前担任深港微电子学院院长、教授,主要研究工作包括CMOS、新型超高密度存储器、GaN器件与系统集成及电子陶瓷,发表学术论文近400篇,其中近190篇被SCI收录,总他引次数近5000次,H影响因子为41,撰写了4本专业书籍的章节并编辑2本书籍,已发表/授权23项美国/欧洲专利以及76项国内专利。成功筹建南科大深港微电子学院(国家示范性微电子学院)、未来通信集成电路教育部工程研究中心、广东省GaN器件工程技术中心、广东省三维集成工程研究中心和深圳市第三代半导体重点实验室。
| 